专业 专注 先进 创新
|
失效分析-刻蚀
失效分析去层刻蚀应用 Failure Analysis Delayer 芯片失效分析 芯片失效分析主要应用于提高芯片良率 (Yield Enhancement) 以及反向工程 (Reverse Engineering),包括芯片开盖 (Chip Decap)、钝化层/绝缘层去除 (Delayer)、铝线/铜线去除、粘附层去除、背硅减薄 (Backside Silicon Access) 等具体技术手段,其中去层技术 (Delayer) 需要完整地去除金属线之间绝缘层,恰到好处地将下一层金属线暴露出来,有时还需要保留金属线之间的过孔 (Via hole),以及去除粘附层,是失效分析中一项具有挑战性的技术。 我们从用户具体要求出发,开发了专门适用于失效分析的反应离子刻蚀机台(SHL FA100/150/200 RIE/ICP),将工艺稳定性调配到最佳状态,同时考虑操作便捷性,让用户可以一键完成指定工艺,整个工艺过程系统全自动执行,该系列机台受到广大业内用户的认可;主要应用于SiO2/SiNx去层,背硅减薄 (Backside Silicon Access)等;与此同时,我们也开发出针对金属层的物理刻蚀机台(SHL FA100/150/200 IBE)。
反应离子刻蚀 (RIE for FA) 主要功能: 1. 钝化绝缘层SiO2/SiNx去层 (Delayer); 2. 可处理最小节点:20 nm; 3. 刻蚀速率:50 ~ 300 nm/min; 4. 刻蚀表面粗糙度 < 1 nm; 5. 刻蚀均匀性 < 5%; 6. 对Cu/Al选择比 > 50; 电感耦合等离子体刻蚀 (ICP for FA) 主要功能: 1. SiO2/SiNx去层、Al/Cu去层、背硅减薄 (Backside Silicon Access); 2. 可处理最小节点:20 nm; 3. 刻蚀速率: SiO2/SiNx: 50 ~ 500 nm/min Al: 100 ~ 300 nm/min Cu: 5 ~ 20 nm/min Si: 500 ~ 4000 nm/min 4. 刻蚀表面粗糙度 < 5 nm; 5. 刻蚀均匀性 < 5%; 离子束刻蚀 (IBE for FA) 主要功能: 1. 金属Al/Cu去层 (Delayer); 2. 可处理最小节点:20 nm; 3. 刻蚀速率 5 ~ 50 nm/min; 4. 刻蚀表面粗糙度 < 5 nm; 5. 刻蚀均匀性 < 5%; 6. 对SiO2/SiNx选择比 ~ 1; 芯片失效分析刻蚀机台应用结果:
钝化层带孔去层刻蚀(SEM)
钝化层带孔去层刻蚀(SEM)
钝化层不带孔去层刻蚀(SEM)
钝化层不带孔去层刻蚀(SEM)
钝化层不带孔去层刻蚀(SEM)
钝化层不带孔去层刻蚀(SEM)
钝化层去层刻蚀(OM)
钝化层去层刻蚀(OM)  M2层 未处理  M2层 已处理  M6层 未处理  M6层 已处理 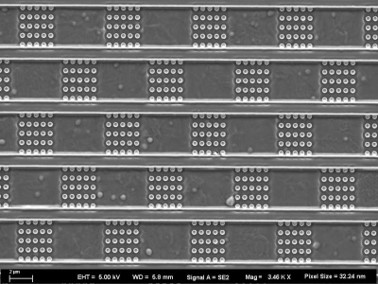 M7层 未处理  M7层 已处理
SHL 200SV-RIE
|