SHL(三和联)离子束在失效分析的应用
作者:
三和联-半导体设备专家
【
原创
】
2025-04-05
离子束刻蚀在芯片失效分析方向的应用主要是用于芯片故障分析和故障定位。当芯片出现故障时,需要对芯片进行分析和定位,以找出故障原因。离子束刻蚀可以通过刻蚀芯片表面来观察芯片内部结构和元器件的状态,从而帮助分析和定位芯片故障。具体应用包括:
1.刻蚀芯片表面
离子束刻蚀可以通过刻蚀芯片表面来观察芯片内部结构和元器件的状态,从而帮助分析和定位芯片故障。
2.制作断面样品
离子束刻蚀可以制作出芯片的断面样品,从而可以观察芯片内部结构和元器件的状态,帮助分析和定位芯片故障。
3.制作透射电子显微镜(TEM)样品
离子束刻蚀可以制作出透射电子显微镜(TEM)样品,从而可以观察芯片内部结构和元器件的状态,帮助分析和定位芯片故障。
4.制作扫描电子显微镜(SEM)样品
离子束刻蚀可以制作出扫描电子显微镜(SEM)样品,从而可以观察芯片内部结构和元器件的状态,帮助分析和定位芯片故障。
离子束刻蚀在芯片失效分析方向的应用非常广泛,可以帮助分析和定位芯片故障,从而提高芯片的可靠性和稳定性。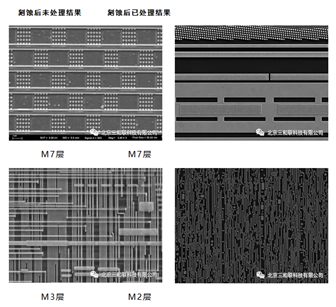
22nm5mm*5mm


M2层
目前基于 IBE 技术的 SHL FA100S-IBE 已用于失效分析中的金属线 Cu、粘附层TaN 以及绝缘层 SiO2 的刻蚀中。
三和联自主研制的离子束刻蚀 (IBE) 系列产品,采用射频离子源技术,具有极好的工艺稳定性与工艺重复性,适用于失效分析,金属刻蚀、磁材料刻蚀等相关应用。
推荐
-

-

QQ空间
-

新浪微博
-

人人网
-

豆瓣

